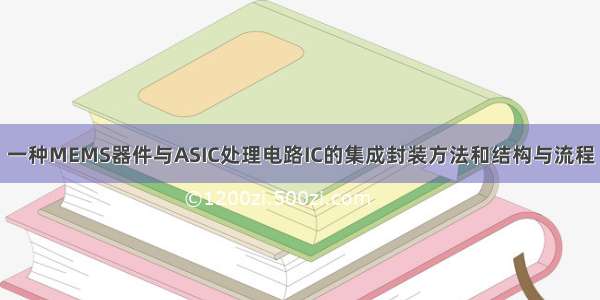
本发明属于微机电系统(MEMS)领域,更具体的涉及一种MEMS器件与ASIC处理电路IC的集成封装方法和结构。
背景技术:
AlN MEMS器件是一种采用ALN为压电材料的传感器或者执行器,不断朝小型化集成化的方向发展,在要求缩小尺寸、增加性能的同时,还必须降低成本。采用ALN材料不仅有好的导热能力,较高的介电常数,还能与CMOS工艺兼容;AlN MEMS器件不仅具有较高的电学特性、较好的机械性能和光学传输特性,制作工艺简单且成本较低,从而广泛应用于工业、医学等。目前产业化商业化应用包括薄膜体声波谐振器、超声波传感器、压电换能器等。
对于紧密复杂的ALN MEMS器件,需要保护器件内部的可动部件,保证器件的高性能指标。为了避免长时间接触复杂的工作环境,后续的集成封装也显得格外重要。目前主要的集成封装技术方案有:美国InvenSense公司提出了一种MEMS-IC单片集成式的MEMS圆片级真空封装的技术方案,采用薄膜体声波器件、超声波传感器等作为衬底,ASIC信号处理IC堆叠其上并且通过其体内的TSV互连实现信号引出;近年来企业以及研究机构多数采用的是Post-CMOS单片集成技术,广泛用于后续的量产化制造,在正常的IC工艺流程结束后,通过MEMS微机械加工进行MEMS器件的制作,实现单片集成MEMS系统;1960年IBM公司开发了倒装芯片封装技术,一般是在芯片的正面制作焊点阵列作为输入、输出端子并以倒扣方式焊接于封装基板上,采用下填充有机物稳固焊接键合过程。
然而,基于TSV技术的圆片级真空封装技术复杂度高、对IC设计影响大,ASIC与MEMS芯片的面积需要保持一致,而IC技术按比例缩小的速度要远超过MEMS技术,要求两者的芯片面积保持一致会导致芯片面积浪费以及成本提高。Post-CMOS单片集成技术虽然对CMOS工艺要求低,但在高温加工ALN MEMS器件时会对CMOS电路产生较大的影响。倒装芯片技术无法将AlN MEMS器件形成闭合空腔结构。
技术实现要素:
本发明的主要目的在于克服现有技术中的上述缺陷,提出一种MEMS器件与ASIC处理电路IC的集成封装方法和结构,用于使MEMS器件实现闭合空腔结构并且能够与ASIC处理电路IC圆片实现电气互联。
本发明采用如下技术方案:
一种MEMS器件与ASIC处理电路IC的集成封装方法,其特征在于,包括如下步骤:
1)在ASIC处理电路IC圆片上光刻图形化沉积一层再布线层;
2)在该再布线层上旋涂一层有机物作为键合层,并光刻形成有微腔阵列;
3)将MEMS器件正面的电极pad层与该微腔阵列对准并键合,以形成闭合空腔结构;
4)将键合后的MEMS器件背面的硅衬底层减薄抛光至所需厚度;
5)将MEMS器件光刻图形化以使电极pad层形成外凸的连接部,在键合层上开孔露出再布线层的电学接触区;
6)在连接部和键合层上制作金属连接件,以使该电极pad层与电学接触区电连接。
所述MEMS器件为超声波传感器、体声波传感器或压电储能器。
所述MEMS器件依次包括所述硅衬底层、氧化层、下电极层、压电层、上电极层、表面钝化层和所述电极pad层。
所述再布线层为Al层或Cu层或Al/Cu层。
所述键合层为苯并环丁烯或BCB层。
所述闭合空腔结构为真空的闭合空腔结构。
步骤4)中,所述所需厚度为小于等于10um。
所述电极pad层为Al层或Cu层或Al/Cu层。
所述金属连接件为焊盘或引线或焊球。
一种MEMS器件与ASIC处理电路IC的集成结构,包括ASIC处理电路IC圆片和MEMS器件,其特征在于,还包括再布线层、键合层和金属连接件;该再布线层位于该ASIC处理电路IC圆片的表面并设有电学接触区;该键合层位于再布线层表面,其设有微腔阵列和开孔,该开孔与电学接触区对应;该MEMS器件的电极pad层与键合层的微腔阵列对准键合形成闭合空腔结构,该电极pad层设有外凸的连接部;该金属连接件与连接部、电学接触区电性连接。
由上述对本发明的描述可知,与现有技术相比,本发明具有如下有益效果:
1、本发明的方法,不仅能够使MEMS器件形成闭合空腔结构、与ASIC处理电路IC圆片之间形成电气互联,避免了ASIC与MEMS芯片的面积不一致导致的集成封装问题,还降低了MEMS器件的整体体积、成本,实现芯片倒装键合、提高成品率。对于未来走向集成封装,后续的测试及其应用提供了便利。
2、本发明采用有机物(优选BCB)键合技术,键合温度温度低,热学、化学、力学稳定性好,与集成电路工艺兼容性好。
附图说明
图1为封装结构图;
图2为本发明方法流程图(再布线层);
图3为本发明方法流程图(键合层);
图4为本发明方法流程图(键合);
图5为本发明方法流程图(减薄抛光);
图6为本发明方法流程图(连接部);
其中:100为ASIC处理电路IC圆片,200为MEMS器件,210为硅衬底层,220为氧化层,230为下电极层,240为压电层,250为上电极层,260为表面钝化层,270为电极pad层,300为再布线层,400为键合层,410为微腔阵列,500为金属连接件。
具体实施方式
以下通过具体实施方式对本发明作进一步的描述。本发明的各附图仅为示意以更容易了解本发明,其具体比例可依照设计需求进行调整。文中所描述的图形中相对元件的上下关系,在本领域技术人员应能理解是指构件的相对位置而言,对应的,以元件在上一面为正面、在下一面为背面以便于理解,因此皆可以翻转而呈现相同的构件,此皆应同属本说明书所揭露的范围。
本发明提出的一种MEMS器件与ASIC处理电路IC的集成封装结构,参见图1,包括ASIC处理电路IC圆片100、MEMS器件200、再布线层300、键合层400和金属连接件500等。该再布线层300位于该ASIC处理电路IC圆片100的表面并设有电学接触区,该再布线层300为Al层或Cu层或Al/Cu层。该键合层400位于再布线层300表面,其设有微腔阵列410和开孔,该开孔与电学接触区对应。该键合层400为苯并环丁烯或BCB层等有机物。
该MEMS器件200的电极pad层270与键合层400的微腔阵列410对准键合形成闭合空腔结构,该电极pad层270设有外凸的连接部,该闭合空腔结构为真空的闭合空腔结构,电极pad层270为Al层或Cu层或Al/Cu层等。该金属连接件500与连接部、电学接触区电性连接,该金属连接件500为焊盘或引线或焊球等。
MEMS器件200为多层薄膜叠层结构阵列,依次包括硅衬底层210(厚度大致为200-500um不等)、氧化层220、下电极层230(Mo、Al、Cu等的一种)、压电层240(AlN,厚度0.1-5μm)、上电极层250(Mo、Al、Cu等的一种)、表面钝化层260(SiO2)以及电极pad层270(Al、Cu、Al/Cu等的一种)。该MEMS器件200不限于此,其可为超声波传感器、体声波传感器或压电储能器等。
优选的,封装后的硅衬底层210厚度不大于10μm,下电极层230采用Mo,压电材料层采用AlN,厚度0.1-5μm。上电极采用Al,表面钝化层260采用氧化层220,电极pad层270采用铝。ASIC处理电路IC为配合MEMS器件200的信号处理电路。
参见图2,本发明还提出一种MEMS器件与ASIC处理电路IC的集成封装方法,其可采用芯片级或晶圆级封装方式,主要包括如下步骤:
1)首先在ASIC处理电路IC圆片100,上制作一层再布线层300,以将MEMS器件200的电极pad层270再布局,并为后续堆叠其上的器件设置电学接触区。如图2所示。
2)在再布线层300之上通过旋涂制作一层有机物构成键合层400,并在该键合层400上光刻形成有微腔阵列410,如图3。
3)对于MEMS器件200,以圆片对圆片或芯片对圆片方式将MEMS器件200的电极pad层270与微腔阵列410对准并在真空条件下键合,形成闭合空腔结构,如图4。
4)将键合至ASIC处理电路IC圆片100的MEMS器件200的硅衬底层210减薄抛光至所需硅厚度,以保证MEMS器件200的工作性能,如图5。
5)采用刻蚀暴露出MEMS器件200正面电极pad层270的局部形成外凸的连接部,且在键合层400上开孔露出再布线层300的电学接触区,MEMS器件200的硅衬底层210可以采用深度反应离子(DRIE)刻蚀,氧化层220、键合层400可以采用反应离子刻蚀(RIE),如图6。
6)在连接部和键合层400上制作金属连接件500,以使该电极pad层270与电学接触区电连接。该金属连接件500可为图形化的AI电极,其可以是焊盘或引线或焊球,如图1。
另外,在制作该金属连接件500前,先制作介质层进行电学隔离,介质层采用氧化硅、氮化硅等无机介质或聚酰亚胺PI、BCB等有机介质。
上述仅为本发明的具体实施方式,但本发明的设计构思并不局限于此,凡利用此构思对本发明进行非实质性的改动,均应属于侵犯本发明保护范围的行为。
技术特征:
1.一种MEMS器件与ASIC处理电路IC的集成封装方法,其特征在于,包括如下步骤:
1)在ASIC处理电路IC圆片上光刻图形化沉积一层再布线层;
2)在该再布线层上旋涂一层有机物作为键合层,并光刻形成有微腔阵列;
3)将MEMS器件正面的电极pad层与该微腔阵列对准并键合,以形成闭合空腔结构;
4)将键合后的MEMS器件背面的硅衬底层减薄抛光至所需厚度;
5)将MEMS器件光刻图形化以使电极pad层形成外凸的连接部,在键合层上开孔露出再布线层的电学接触区;
6)在连接部和键合层上制作金属连接件,以使该电极pad层与电学接触区电连接。
2.如权利要求1所述的一种MEMS器件与ASIC处理电路IC的集成封装方法,其特征在于,所述MEMS器件为超声波传感器、体声波传感器或压电储能器。
3.如权利要求1所述的一种MEMS器件与ASIC处理电路IC的集成封装方法,其特征在于,所述MEMS器件依次包括所述硅衬底层、氧化层、下电极层、压电层、上电极层、表面钝化层和所述电极pad层。
4.如权利要求1所述的一种MEMS器件与ASIC处理电路IC的集成封装方法,其特征在于,所述再布线层为Al层或Cu层或Al/Cu层。
5.如权利要求1所述的一种MEMS器件与ASIC处理电路IC的集成封装方法,其特征在于,所述键合层为苯并环丁烯或BCB层。
6.如权利要求1所述的一种MEMS器件与ASIC处理电路IC的集成封装方法,其特征在于,所述闭合空腔结构为真空的闭合空腔结构。
7.如权利要求1所述的一种MEMS器件与ASIC处理电路IC的集成封装方法,其特征在于,步骤4)中,所述所需厚度为小于等于10um。
8.如权利要求1所述的一种MEMS器件与ASIC处理电路IC的集成封装方法,其特征在于,所述电极pad层为Al层或Cu层或Al/Cu层。
9.如权利要求1所述的一种MEMS器件与ASIC处理电路IC的集成封装方法,其特征在于,所述金属连接件为焊盘或引线或焊球。
10.一种MEMS器件与ASIC处理电路IC的集成结构,包括ASIC处理电路IC圆片和MEMS器件,其特征在于,还包括再布线层、键合层和金属连接件;该再布线层位于该ASIC处理电路IC圆片的表面并设有电学接触区;该键合层位于再布线层表面,其设有微腔阵列和开孔,该开孔与电学接触区对应;该MEMS器件的电极pad层与键合层的微腔阵列对准键合形成闭合空腔结构,该电极pad层设有外凸的连接部;该金属连接件与连接部、电学接触区电性连接。
技术总结
本发明提供一种MEMS器件与ASIC处理电路IC的集成封装方法和结构,首先在ASIC处理电路IC圆片的正面形成一层再布线层,紧接着在再布线层涂敷一层有机物,光刻刻蚀图形化形成微腔阵列;然后将MEMS器件的正面电极pad层与微腔阵列对准键合形成闭合空腔结构;将MEMS器件背面硅衬底层减薄抛光至所需厚度,光刻图形化刻蚀暴露出MEMS器件正面电极pad层、再布线层的电学接触区;最后,制作金属连接件连接电极Pad层以及电学接触区。本发明降低了MEMS器件的整体体积、成本,实现芯片倒装键合、提高成品率。
技术研发人员:马盛林;龚丹;邱奕翔
受保护的技术使用者:厦门大学
技术研发日:.02.19
技术公布日:.06.04














